پرونده:Illustration of C-V measurement.gif
Illustration_of_C-V_measurement.gif (۳۲۲ × ۳۰۸ پیکسل، اندازهٔ پرونده: ۹۳ کیلوبایت، نوع MIME پرونده: image/gif، چرخشدار، ۱۸ قاب، ۵٫۴ ثانیه)
تاریخچهٔ پرونده
روی تاریخ/زمانها کلیک کنید تا نسخهٔ مربوط به آن هنگام را ببینید.
| تاریخ/زمان | بندانگشتی | ابعاد | کاربر | توضیح | |
|---|---|---|---|---|---|
| کنونی | ۱۷ مهٔ ۲۰۱۰، ساعت ۱۹:۲۶ | 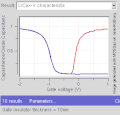 | ۳۲۲ در ۳۰۸ (۹۳ کیلوبایت) | Beatnik8983 | {{Information |Description={{en|1=C-V measurements can reveal oxide thickness, oxide charges, contamination from mobile ions, and interface trap density in wafer processes. In this image the C-V profile for a bulk p-type substrate MOSCAP with different ox |
کاربرد پرونده
صفحهٔ زیر از این تصویر استفاده میکند:
کاربرد سراسری پرونده
ویکیهای دیگر زیر از این پرونده استفاده میکنند:
- کاربرد در en.wikipedia.org
- کاربرد در hu.wikipedia.org
- کاربرد در ja.wikipedia.org
- کاربرد در ru.wikipedia.org
- کاربرد در zh.wikipedia.org

